Servicios de proceso TSV
TSV (silicon through hole) es una tecnología avanzada de encapsulamiento que permite la integración de diferentes chips funcionales haciendo que los canales de silicio pasen verticalmente a través de los diferentes chips o capas que componen la pila. TSV completa principalmente la interconexión eléctrica vertical de los agujeros de silicio llenando materiales conductores como el cobre, reduciendo el retraso de la señal, reduciendo los condensadores e inductores, logrando un bajo consumo de energía y comunicación de alta velocidad del chip, aumentando el ancho de banda y logrando la necesidad de miniaturización de la integración de dispositivos.
Anteriormente, la mayoría de las conexiones entre chips eran horizontales, y la creación de TSV permitió apilar verticalmente varios chips. Las protuberancias de chip de Unión de alambre y invertida proporcionan interconexión eléctrica al exterior del núcleo, RDL (cableado reorientado) proporciona interconexión horizontal dentro del núcleo y TSV proporciona interconexión vertical dentro del chip.
El TSV se aplica principalmente en tres direcciones: conexión trasera, encapsulamiento 2.5d, encapsulamiento 3D.
Conexión en la parte posterior vertical. Apilamiento sin chip, como "simple conexión posterior". El TSV se encuentra en el núcleo activo para conectarse a la almohadilla en la parte posterior del chip.
Embalaje 2.5d. El núcleo está conectado a la capa intermedia de silicio, y el TSV se encuentra en la capa intermedia.
Paquetes de software 3D. El TSV se encuentra en el núcleo activo para lograr la pila de chips.
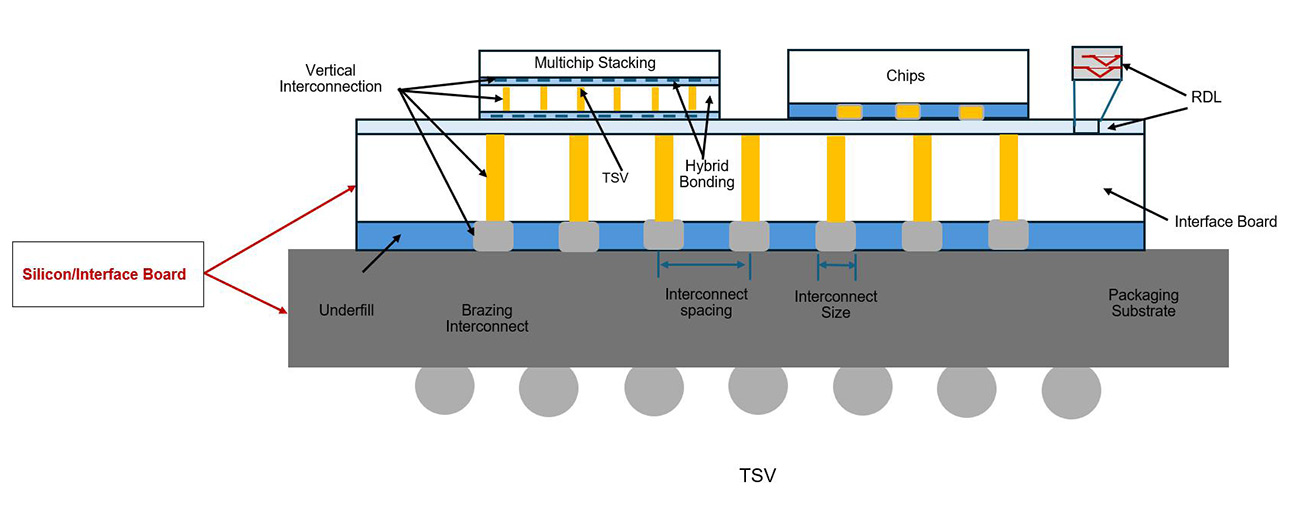
Nuestro proceso:
Agujero: La formación de agujeros se puede completar mediante perforación láser, grabado en seco, grabado húmedo, etc.
Depósito de la capa aislante: La capa aislante en el agujero de TSV se utiliza para lograr el aislamiento entre el sustrato de silicio y el canal de transmisión en el agujero para evitar fugas y conversaciones cruzadas entre los agujeros a través de tsv.
Depósito de barreras / capas de semillas: El cobre se utiliza comúnmente como material de interconexión metálica interna del agujero de paso de TSV en el proceso intercalar de TSV 2.5d.
Relleno de recubrimiento: El relleno de agujeros profundos de TSV es una tecnología clave para la integración 3d, que está directamente relacionada con el rendimiento eléctrico y la fiabilidad de los dispositivos posteriores. Los materiales que se pueden llenar incluyen cobre, tungsteno, polisilicio, etc.
CMP (pulido químico - mecánico): La tecnología CMP se utiliza para eliminar el dieléctrico de sílice, la capa de bloqueo y la capa de semillas de cristal de la superficie de silicio.
Adelgazamiento de obleas: Después de que la superficie del chip se aplana, la parte posterior del chip se adelgaza para exponer el tsv.



